Backgrinding wheel, Dicing blade
주식회사 로이드는 이화다이아몬드공업의 공식 대리점입니다.
Backgrinding wheel, Dicing blade
주식회사 로이드는 이화다이아몬드공업의 공식 대리점입니다.

이화다이아몬드공업(주)
이화다이아몬드는 1975년에 설립되었으며 세계 3대 다이아몬드 공구 제조업체 중 하나입니다.
반도체, LCD 패널 및 산업체에 제품을 공급하고 있으며, 삼성전자, TSMC, ASE, SPIL 등 전 세계 유수 기업에 공급하고 있습니다.
백그라인딩 휠 (Backgrinding Wheel)
VITRIFIED BACK GRINDING WHEEL (NANO POL)
Technology
· 웨이퍼 표면 거칠기 및 다이 강도를 향상시킬 수 있음
· 연마(그라인딩) 응력 및 웨이퍼 에지 치핑을 감소시킬 수 있음
· 팁(tip) 부의 다이아몬드를 균일하게 분포 시킬 수 있음
· 기공률, 기공 형상 및 기공 크기 제어를 조절할 수 있음
· 최대 17µm까지 실리콘 웨이퍼 연마 가능 (초박형 웨이퍼)
· TSV 및 일반(지문 인식용) 컴파운드 웨이퍼에 대해 우수한 연마 성능 제공

Si Wafer Grinding Wheel


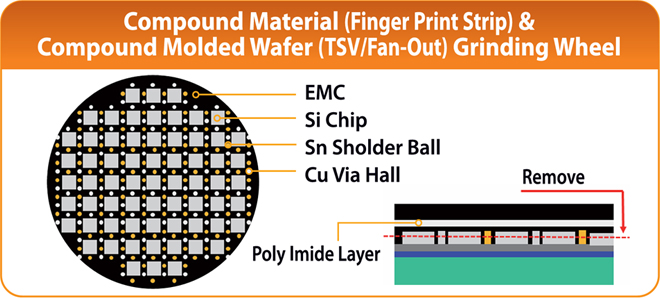
| Material | Wheel Spec. | ||||
|---|---|---|---|---|---|
| Pure Compound (Ex. EMC) | #800~#2000 VSP3 #800~#2000 VSP5 |
||||
| Compound + Silicon Chip | Z1 #800 VSP3 + Z2 #5000 VK8HS Z1 #800 VSP3 + Z2 #5000 VK8B |
||||
| Compound + Silicon Chip + Copper Via | Z1 #800 VSP3 + Z2 #5000 VK8HS Z1 #800 VSP3 + Z2 #5000 VK8B |
||||
| Compound + Silicon Chip + Copper Via Polyimide + Solder |
Z1 #800 VSP3 + #3000 VSPS10 Z1 #800 VSP3 + #3000 VSPBT7 |
BACK GRINDING WHEEL
Advantages
1. Vitrified bond (#400~800)
② 낮고 안정적인 연마 전류 및 더 긴 휠 수명
2. Resin bond (#325~600)
② 휠 수명을 저하시키지 않으면서 우수한 연마 성능 제공
1. Resin bond (#2000 ~ #4000)
② 경쟁사 대비 현저히 긴 휠 수명
③ #3000~#4000: 우수한 표면 거칠기 및 절단(Sawing) 마크 최소화

Specifications
| Applications | D | W | X | ||||
|---|---|---|---|---|---|---|---|
| Rough grinding | Φ200~Φ204 Φ250 Φ300~Φ304 |
2~4 | 5~7 | ||||
| Fine grinding |
| Bond type | Machine / S·K type | Dimensions | |||||
|---|---|---|---|---|---|---|---|
| Resin | BG01 | DISCO | D | DISCO | Diameter | ||
| Vitrified | BG02 | OKAMOTO | O | OKAMOTO | Width | ||
| – | TSK | T | TSK | Depth | |||
| Mesh size | Bond name |
|---|---|
| #270 | VA |
| #325 | VCL |
| #400 | RB |
| #600 | RS |
| #800 | REC |
| #1200 | RDC |
| #1500 | SWB |
| #2000 | SWA |
| #3000 | SWC |
| #4000 | SWE |
Performance Data
| Performance comparison : Z1 | EHWA : RSL | Competitor | |||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|
| Specification | Bond type | Porous structured resin | Porous structured resin | ||||||||
| Mesh size | #400~#600 | #320 | |||||||||
| Machine | DISCO 8760 | TSK PG300 | DISCO 8760 | TSK PG300 | |||||||
| Grinding ability [Max grinding current, A] |
Around 12~13 | 9~10A | Around 13~14 | 10~11A | |||||||
| Life time [Wafers / wheel] |
Around 18K | Around 12K | Around 13K | Around 10K | |||||||
| Roughness [Rmax, ㎛] | Around 3~4 | Around 4~5 | |||||||||
| Performance comparison : Z2 | EHWA : RSL | Competitor | |||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|
| Specification | Bond type | Wear resistant porous structured resin | Porous structured resin | ||||||||
| Mesh size | #2000~#3000 | #2000 | |||||||||
| Machine | DISCO 8760 | TSK PG300 | DISCO 8760 | TSK PG300 | |||||||
| Grinding ability [Max grinding current, A] |
Around 12~13A | 9~10A | Around 13~14 | 10~11A | |||||||
| Life time [Wafers / wheel] |
Around 18K | Around 12K | Around 12K~20K | Around 12K | |||||||
| Roughness [Ra, nm] | Around 7~8 | Around 7~8 | |||||||||
Wafer edge shape for ultra thin wafer


Polishing Wheel(DP)
· Wool Felt + ZrO2 (250nm)
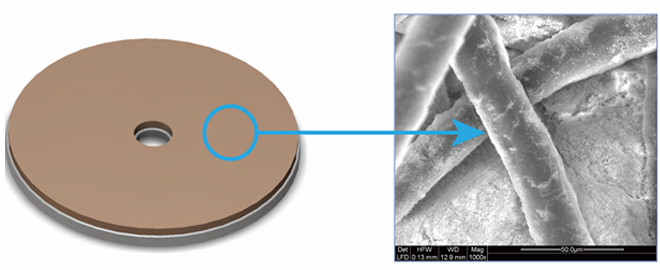
· Silicon Wafer
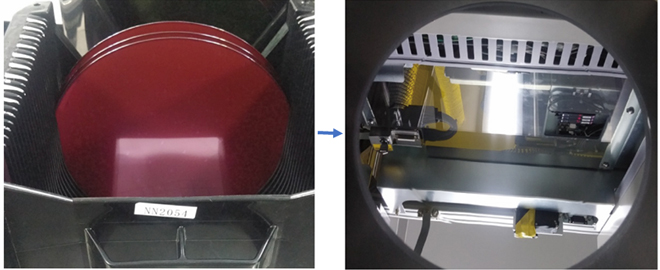
Z1 : EHWA BACK GRINDING WHEEL / Z1 : EHWA BACK GRINDING WHEEL / Z3 : EHWA DP-350D
Roughness Result

WAFER ROUGHNESS TEST (Field test)
· Sampling Interval : 1.0㎛
· Objective : 20X
· Cutoff Filter : 80.00 (㎛)
· Machine : MP20900+

TOTAL ROUSHNESS AVERAGE
· Ra Average = 1.64 Å
다이싱 블레이드 (Dicing Blade)
Micro Blade(Resin)
Advantages
· Maintains free cutting action at high RPM and fast feed rates
· Eliminate chipping during the sawing operation
Applications
· Sawing of packages such as QFN, FBGA, CSP, MCP, POP, PBGA
· Sawing and grooving of Ferrite, Ceramics, Glass, Quartz, Sapphire
· Eliminate chipping during the sawing operation
Available Product Spec and Bond Series
| Performance comparison : Z2 | Minimum Thickness (mm) | ||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|
| Metal Bond | Resin Bond | Electroformed Bond | |||||||||
| 52~60 nm (2.5 inch) | 0.10 | 0.10 | 0.08 | ||||||||
| 75~78 (3 inch) | 0.15 | 0.15 | – | ||||||||
| 100~115 (4 inch) | 0.15 | 0.20 | – | ||||||||
| 120~130 (5 inch) | 0.20 | 0.25 | – | ||||||||

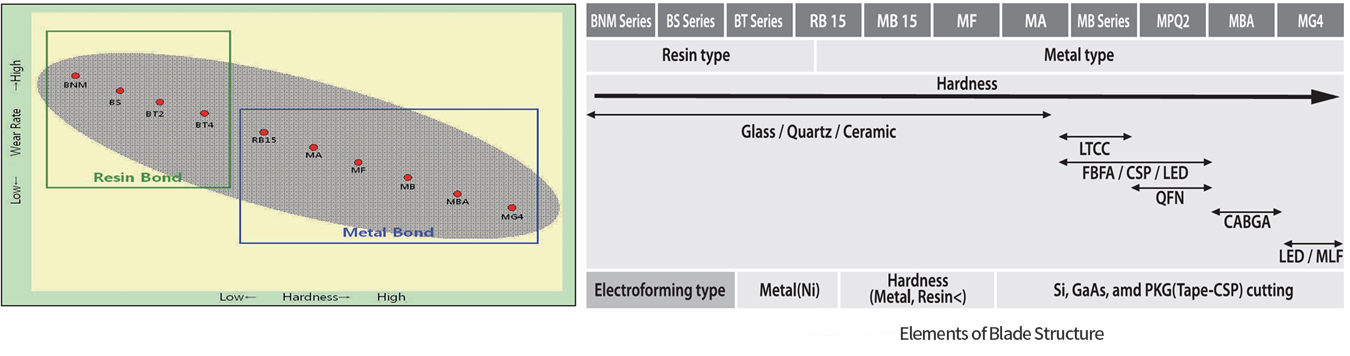
![UUU3]](https://lloydcompany.co.kr/wp-content/uploads/2025/12/UUU3.jpg)
EHWA New Blade
· No diamond exposure of blade surface type
· Excellent cutting quality at Cu burr, Chipping and shape maintaining
· Superior blade life time and hardness than conventional blade

Cutting surface of the PKG
Dicing Blade
Advantages
· Minimized chipping and superior consistency in quality through stringent particle
· Size distribution control
· Improve productivity by high feed speed
· Providing an optimized solution to the customers

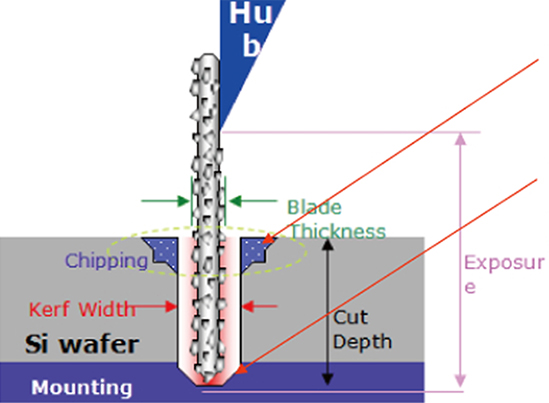
Wafer Top Side :
Wet Cutting with Coolant In general, fine diamond grit
leads to small top side Chipping
Wafer Back Side :
Dry Cutting without Coolant In general, coarse diamond
grit minimizes back size chipping to its cutting ability
and less load imposed on each grit

Top chipping

Side & back chipping
Developing New Bond
Application
Si and Compound semiconductor
Features
Small top and backside chipping
Improve productivity by high feed speed
기타
| CVD CMP 패드 컨디셔너 | New BSL CMP 패드 컨디셔너 | 전착 CMP 패드 컨디셔너 | 엣지 그라인딩 휠 | 폴리싱휠(GDP) | 마이크로블레이드(메탈) | 전주 블레이드 |
 |
 |
 |
 |
 |
 |
 |

